股票代码:300410
400-665-5066
BGA焊接一般采用的回流焊的原理,回流焊的优点是有可能在同一时间内完成所有的焊点,从而实现生产成本降到最低的目的。从本质上来讲,大部分SMT焊点出现空洞的原因是再流焊接过程中,熔融焊点截留的助焊剂挥发物在凝固期间没有足够的时间及时排出而产生的。
在一般情况下,BGA焊点焊膏中的助焊剂会被再流焊接过程中的熔融焊锡“聚合力”驱赶出去。但是,如果熔融焊料凝固期间存在截留有助焊剂,就会形成气泡,形成的气泡如果不能及时排出,那么在焊点凝固后就会形成空洞。通常情况下,BGA锡球气孔大小要求不能超过球体20%,超过20%则被判为拒收。除了上述情况,回流焊温度太低、锡膏搅拌时间不够、锡膏回温时间少、车间湿度太高、焊点合金的晶体结构不合理、PCB板的设计错误、焊球在制作过程中夹杂的空洞等原因,都会造成BGA焊接气泡空洞率上升。

在SMT行业中,x-ray检测设备是产品生产过程监控质量、提高品质不可或缺的一份子,它可以迅速找到缺陷的源头,缩短试制的时间,降低返修率,对降低BGA焊接气泡空洞率起着至关重要的作用,那么,xray如何检测BGA焊接气泡空洞的呢?
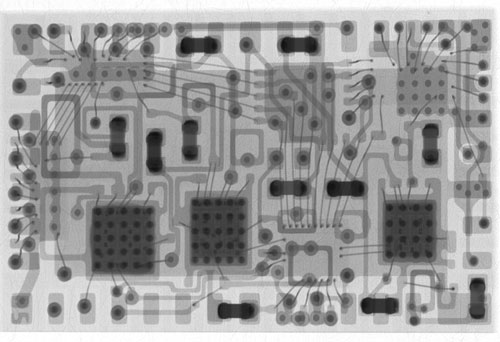
正业科技x-ray检测设备能够对被测物内部结构进行实时拍照检测,可实现2.5D检测。拥有记忆编程,根据提前预设好运动路径,进行自动多点位检测,定位准确,检测效率高,方便小批量重复检测,配备了超大导航窗口,用鼠标就可以点击被测图像任意区域。自主研发的气泡自动测算功能可以一键自动测算检测产品气泡及空洞占空比,自动测算出芯片空洞率和最大气泡尺寸,可满足制造行业厂商的自动化产线的需求。
以上就是关于BGA焊接出现气泡空洞原因和x-ray检测相关内容的介绍,感兴趣的朋友欢迎与正业科技联系。