股票代码:300410
400-665-5066
随着摩尔定律逼近物理极限,先进封装成为延续芯片性能提升的核心路径,Fan-Out、2.5D/3D IC、Chiplet(芯粒)、硅光集成等新技术的落地,对芯片内部互连结构的精度与可靠性提出极致要求。在此背景下,半导体 XRAY 检测设备凭借无损穿透、高分辨率成像、三维可视化等核心优势,成为半导体封装全流程中不可或缺的 “工业显微镜”,破解传统检测技术难以覆盖的微观缺陷难题。

在半导体先进封装工艺中,TSV(硅通孔)、微凸点(Microbump)、RDL(再布线层)、底部填充胶(Underfill)等关键结构尺寸仅为数微米至数十微米,且深埋于多层介质之中,传统电测与光学检测易受遮挡,无法精准捕捉内部状态。而半导体 XRAY 检测设备搭载高能微焦点射线源(焦点<5μm)与高灵敏度探测器,可穿透封装材料,清晰呈现微观结构的形貌与连接状态,实现缺陷的精准识别。
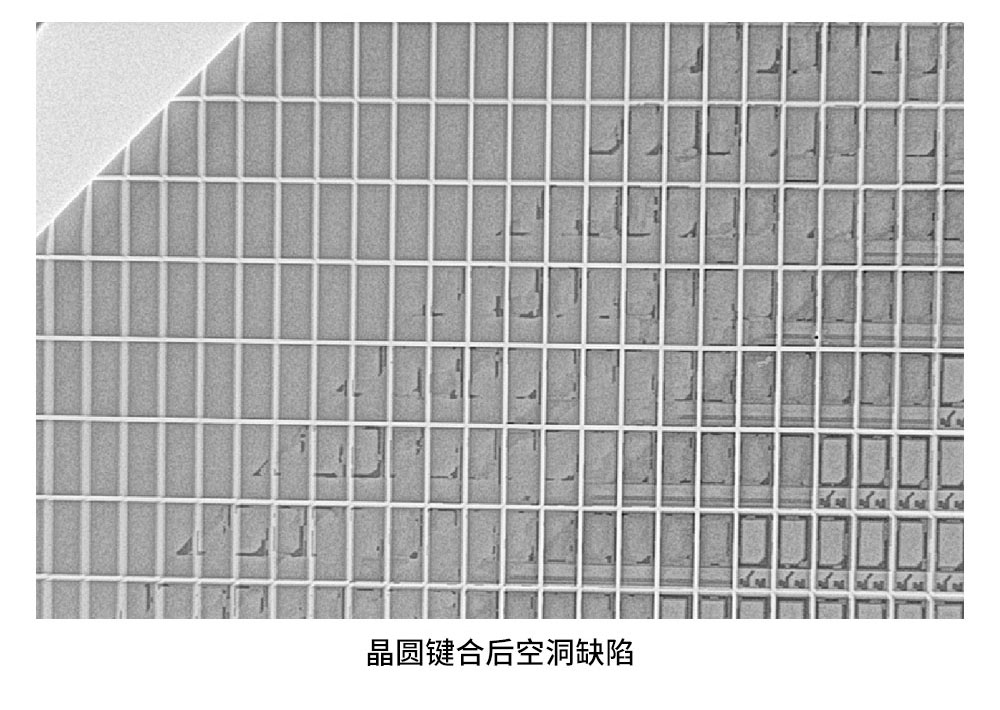
针对不同先进封装场景,半导体 XRAY 检测设备展现出强大适配性:在 3D 堆叠芯片封装中,可精准检测 TSV 是否完全贯通、有无空洞或裂纹,保障垂直互连可靠性;在 Chiplet 集成工艺中,能验证微凸点的对齐精度、焊接质量,杜绝冷焊、缺失等隐患;在底部填充工序后,可评估胶体填充均匀性,识别气泡、分层等缺陷,避免芯片热管理与电性能失效。这些检测能力直接决定芯片的长期稳定性,是车规级、高端消费电子芯片量产的核心保障。
前沿应用中,半导体 XRAY 检测设备的技术升级持续突破边界:原位(in-situ)XRAY 观测技术可在温控、应力环境下,实时捕捉热循环或机械载荷下互连结构的演变,为失效机理研究提供直接数据支撑;AI 智能算法的融入,通过学习海量缺陷样本,实现微凸点塌陷、TSV 偏移等复杂缺陷的自动识别,判别准确率超 95%,大幅降低人工依赖,提升检测效率。
作为半导体检测领域的标杆企业,正业科技半导体 XRAY 检测设备凭借硬核实力成为行业首选:微焦点射线源与 AI 超分辨率增强算法,缺陷识别准确率≥99.9%,完美适配微凸点、TSV 等微观结构检测;支持与 MES 系统无缝对接,助力产线高效运行。依托近三十年技术积淀与完善的全国服务网络,提供 7×24 小时技术支持、已获全球知名半导体厂商采购,为先进封装工艺筑牢品质防线。
